> otsuka微米光学薄膜测厚仪OPTM-A1otsuka微米光学薄膜测厚仪OPTM-A1|OPTM-A2|OPTM-A3
通过使用微光在微小区域中测量绝对反射率,可以进行高精度的膜厚和光学常数分析的设备。
诸如各种膜,晶片,光学材料和多层膜之类的涂膜的厚度可以无损且非接触地测量。1秒/点的高速测量是可能的。它还配备了软件,即使是初学者也可以轻松分析光学常数。
可以根据样品的形状和位置轻松定制测量顺序。
*以上规格为自动XY工作台。
* 1膜厚范围转换为SiO 2。
* 2请与我们联系以获取300 mm位移台。
* AC / DC电源单元
半导体晶体管通过控制电流通电状态来传输信号,但是为了防止电流泄漏和另一个晶体管的电流通过任意通道而在晶体管之间进行绝缘。嵌入绝缘膜。SiO 2(二氧化硅)和SiN(氮化硅)用作绝缘膜。SiO 2用作绝缘膜,SiN用作介电常数比SiO 2高的绝缘膜,或者在用CMP去除不必要的SiO 2时用作阻挡层,然后也去除SiN。以这种方式,必须测量这些膜厚度以用作绝缘膜并进行精确的工艺控制。
液晶显示器通常具有右侧所示的结构。CF在一个像素中具有RGB,是一种非常精细的分钟图案。主流的CF膜形成方法是在玻璃的整个表面上施加基于颜料的彩色抗蚀剂,通过光刻对其进行曝光和显影,而仅留下每个RGB的图案部分。此时,如果彩色抗蚀剂的厚度不恒定,则作为彩色滤光片可能引起图案变形和颜色变化,因此控制膜厚度值很重要。
近年来,使用具有各种功能的高性能膜的产品已经变得广泛,并且根据应用,可能需要在膜表面上具有诸如耐磨性,耐冲击性,耐热性和耐化学性的性质的保护膜。有。通常形成硬涂层(HC)膜作为保护膜层,但是取决于HC膜的厚度,它可能不能用作保护膜,膜中可能发生翘曲,或者可能导致外观不均匀或变形。因此,必须控制HC层的厚度值。
ITO(氧化铟锡)是用于液晶显示器的透明电极材料,由于成膜后的退火处理(热处理)而具有改善的导电性和颜色。那时,氧状态和结晶度也改变,但是该改变可能相对于膜的厚度以逐步的梯度改变,并且不能被认为是具有光学均匀组成的单层膜。对于这种ITO,我们将介绍一个使用倾斜模型测量上界面和下界面的nk的倾斜度的示例。
如果样品的表面具有粗糙度,则将表面粗糙度建模为“粗糙度层”,其中以1:1的比例混合大气(Air)和膜厚度材料,并分析粗糙度和膜厚度。有可能。这是测量表面粗糙度为几纳米的SiN(氮化硅)的示例。
通过形成具有受控的膜厚度和nk的膜,干涉滤光片可以在指定的波长带中具有任意的反射率和透射率。其中,通过将高折射率层和低折射率层的形成重复成对(一组)多次来形成具有特别高精度的膜。描述了使用超晶格模型测量和分析这种样品的示例。
有机EL材料易受氧气和湿气的影响,并且在正常气氛下可能会发生变化或损坏。因此,成膜后立即用玻璃密封。这是在玻璃密封时测量玻璃膜厚度的示例。无干扰层模型用于中间的玻璃和空气层。
要求材料nk通过最小二乘法拟合来分析膜厚值(d)。如果nk未知,则将d和nk分析为变量参数。但是,在d为100nm以下的超薄膜的情况下,d和nk无法分离,因此精度降低,无法得到正确的d。在这种情况下,测量多个具有不同d的样本,并假设nk相同,进行同时分析(在多个点进行相同的分析)。这使得可以精确地获得nk并精确地获得d。
在基板表面不是镜面的,粗糙度大的样品的情况下,由于散射而使测定光减少,反射率比实际低。通过使用界面系数考虑基板表面的反射率的降低,可以测量基板上的薄膜的厚度值。作为示例,我们将描述测量在细线修饰的铝基板上的树脂膜的厚度的示例。
DLC(类金刚石碳)是一种无定形的碳基材料。它具有诸如高硬度,低摩擦系数,耐磨性,电绝缘性,高阻隔性,表面改性和与其他材料的改善的相容性等特征,并且被用于各种应用中。近年来,根据每种应用对膜厚测量的需求不断增长。
○齿轮○轴

类型
OPTM-A1
OPTM-A2
OPTM-A3
波长范围
230-800纳米
360-1100纳米
900-1600纳米
膜厚范围* 1
1 nm至35μm
7 nm至49μm
16 nm至92μm
样本数量* 2
最多200 x 200 x 17毫米
光斑直径
φ5,φ10,φ20,φ40
类型
自动XY载物台类型
固定框类型
内置头型
尺寸
(宽x深x高)
556 x 566 x 618毫米
368 x 468 x 491毫米
210 x 441 x 474毫米
90 x 250 x 190毫米*
重量
66公斤
38公斤
23公斤
4公斤*
最大耗电量
AC100V±10V 500VA
AC100V±10V 400VA

自动XY载物台类型

内置头型
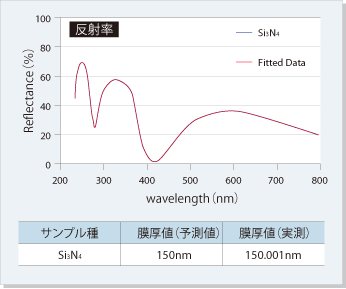
测量例
DLC厚度的测定通常通过准备监视样品并用电子显微镜观察其截面来进行,但通过大冢电子公司采用的光学干涉型膜厚计,进行无损且高速的测定。有可能。通过改变测量波长范围,可以测量从超薄膜到超厚膜的宽膜厚范围。
通过采用独特的显微镜光学系统,可以实际测量成形样品而不是监测样品。另外,在检查监视器上的测量位置的同时进行测量对于分析异常原因很有用。
我们将准备一个支持各种形状的定制倾斜/旋转平台。可以测量实际样品的任意多个点。
不知道材料的光学常数(nk)是光学干涉型薄膜厚度系统的弱点而无法测量准确的薄膜厚度的问题是一种独特的分析方法:使用多点分析来预先准备厚度。通过同时分析多个不同的样本,与过去相比,可以以极高的精度获得nk。
通过对来自NIST(美国国家标准技术研究院)认证的标准样品进行校准,可以保证可追溯性。
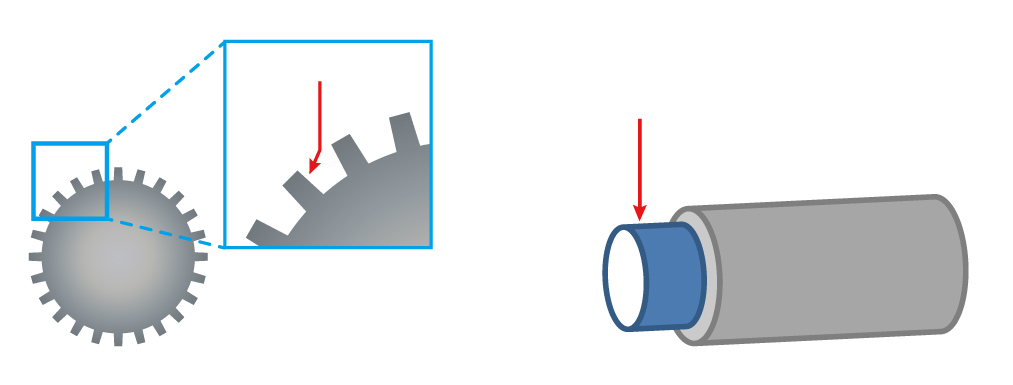
| 产品名称 : | otsuka微米光学薄膜测厚仪OPTM-A1 |
| 产品品牌 : | 大塚otsuka |
好评度